先進半導體封裝熱處理設備
物聯網、5G、AI等技術的普及,帶動高效能半導體需求激增。透過微型化實現高整合度在技術和成本上正在接近極限,因此2.5D、3D等先進的半導體封裝技術備受關注。我們為先進半導體封裝提供各種熱處理設備,並將繼續為下一代半導體的製造做出貢獻。
先進半導體封裝為
先進的半導體封裝是一種在單一封裝中包含多個具有不同功能的半導體晶片並以高密度安裝多個晶片(小晶片)的半導體產品。這些被稱為 2.5D-IC 和 3D-IC。與每個晶片單獨封裝相比,晶片之間的距離更短,從而增加了訊息傳輸的速度。此外,比起將不同功能整合製作成一個大晶片,將不同功能的晶片組合起來可以降低成本,提高產量,增加生產率。
傳統上,半導體製造過程分為兩部分,代工廠負責前段製程,OSAT 負責後段製程。然而,在先進半導體封裝的製造中,前段與後段製程的技術都可以利用,因此兩個領域都在湧現參與者。
高效能的先進半導體封裝技術廣泛應用於AI、高效能運算、5G通訊、智慧型手機、物聯網設備、自動駕駛等眾多領域和產品。

先進半導體封裝對應熱處理製程
除了對印刷電路板(PCB) 進行乾燥以及對Si 中介層、RDL(再分佈層)、玻璃中介層等進行各種熱處理之外,我們還對應焊料凸塊形成後的回烤以及晶片成型後的烘烤。我們在提供FO-WLP(扇出型晶圓級封裝)和WL-CSP(晶圓級晶片尺寸封裝)熱處理設備方面也有豐富的經驗。
我們充分利用半導體製造設備和液晶基板設備製造方面累積的經驗和技術,為先進半導體封裝提供與各種製造流程相容的設備。
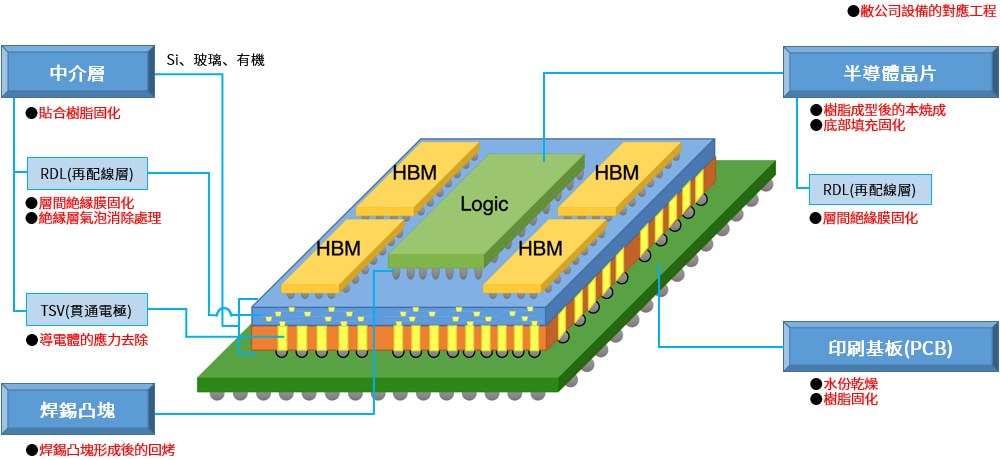
產品系列
| 機台型式 | 量産用 | 研究開發用 | |||
|---|---|---|---|---|---|
| 潔淨烤箱 | 直立爐 | 大口徑直立型系統 | 潔淨烤箱 | ||
| SO2-12-F / SO2-30-F SO2-12L-F / SO2-30L-F |
SO2-60-F | VF-5700B-F2 VF-5900B |
VFS-4000 | CLH-21CD(H) CLH-35CD(H) |
|
| FO-WLP | 〇 | - | 〇 | - | 〇 |
| FO-PLP | 〇 | 〇 | - | 〇 | 〇 |
| Si中介層 | 〇 | - | 〇 | - | 〇 |
| 玻璃中介層 | 〇 方形基板對應 |
〇 方形基板對應 |
〇 僅對應圓形晶圓 |
〇 方形基板對應 |
〇 方形基板對應 |
| 有機中介層 | 〇 方形基板對應 |
〇 方形基板對應 |
〇 僅對應圓形晶圓 |
〇 方形基板對應 |
〇 方形基板對應 |
| 對應基板 尺寸 (mm) |
Φ300 300×300 |
510×515 600×600 |
Φ300 | 300×300 510×515 600×600 |
Φ300 300×300 |
| 爐數 | 2 | 2 | 1 | 1 | 1 |
| 最大處理 片數*1/爐 |
50 枚*2, 52 枚*3 |
24 枚 | 75 枚*4, 100 枚*5 |
12 枚 | - |
| 加熱方式 | 熱風循環式 | 阻抗加熱式 | 熱風循環式 | ||
| 基板搬送 | 機器手臂搬送 | 手動 | |||
| I/O Port数 (FOUP) | 4 | 4 | 2 | 2 | - |
| 使用温度範圍 | 70~450℃*2, 70~400℃*3 |
70~300℃ | ~750℃ | ~600℃ | RT+70~530℃ |
| 残留氧氣濃度 | 10ppm以下 | 20ppm以下 | |||
| 自動清潔 | - | - | 高温燒除 | - | |
*1 基板厚度與翹曲的影響、處理片數會有增減的情況。
*2 SO2-12-F/SO2-30-F的時候
*3 SO2-12L-F/SO2-30L-F的時候
*4 VF-5700B-F2的時候
*5 VF-5900B的時候





